据悉,台积电准备将CoWoS封装技术的产能从每月8000片wafer,提升到今年底的11000 WPM;而到2024年底则要到20000WPM。新的封装技术已经出现,对于传统的封装手段,是否应该摈弃呢?
封装工艺
封装是芯片中非常重要的异性工艺,封装技术会影响到芯片后期的使用效果。
2.5D/3D封装工艺
前不久台积电刚刚开启了先进后道Fab 6工厂(Advanced Backend Fab 6),针对前道3D堆叠SoIC技术(包括CoW和WoW)和后道3D封装技术(InFO和CoWoS)做产能扩充。这家工厂的部分能力和产能对于多chiplet封装与测试很重要。
目前台积电CoWoS(Chip-on-Wafer-on-Substrate)先进封装技术最大的客户就是英伟达和AMD,随后是博通(Broadcom)。
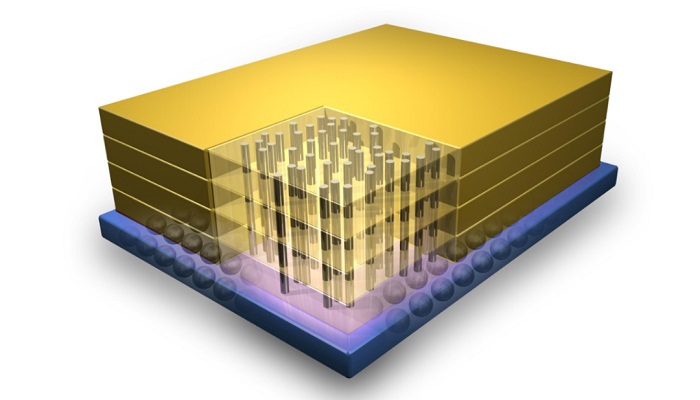
封装技术现状
关于先进封装技术,主要涉及到三个部分,逻辑与存储芯片IDM、具备先进或成熟工艺的foundry厂、OSAT。
越早署先进封装技术,处于领跑位置的参与者,必然是战局里的赢家,即便初期产能受限,可能会成为其阻碍。
麦肯锡认为,在高端的先进封装市场,OSAT以及技术水平处在较低级别的foundry和IDM,这些角色的发挥空间会很有限。
2.5D封装应用主要来自HPC应用,以数据中心为主。其实Intel最近改变桌面CPU的系列产品命名,将Meteor Lake称作“英特尔酷睿Ultra”第1代处理器,就可以看做PC行业步入2.5D/3D先进封装的标志。3D封装,可以用于大规模AI芯片。
回到标题,传统技术是否该被淘汰?就目前来说,新的封装技术还没有广泛的使用,传统的封装技术依然有其突出的性能优势。所以现在就淘汰传统封装技术是非常不现实的,以后随着技术的进步,产品的更迭,新的封装技术可能会逐渐取代传统封装技术。
Copyright © 2002-2022 长龙鑫 版权所有 Powered by EyouCms 地址:广东省深圳市宝安区新安街道创业二路 新一代信息技术产业园C座623号 备案号:粤ICP备17052896号 网站地图